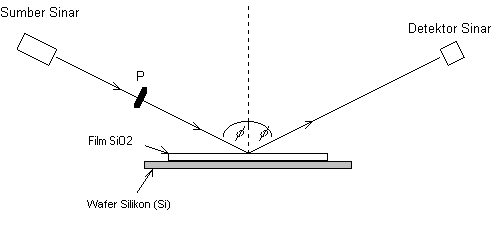
Beberapa faktor keuntungan yang dapat diperoleh dari alat ini antara lain : (i) tidak mengganggu sifat - sifat fisis dari permukaan sampel yang diukurnya untuk panjang gelombang tertentu yang dapat dipilih, (ii) cukup sensitif untuk pengukuran antarmuka (interface) dari suatu struktur media yang memiliki ukuran cukup kecil, (iii) dapat dioperasikan pada udara bebas (tidak harus pada kondisi khusus seperti ruang hampa), dan (iv) dapat diperoleh hasil secara langsung (in situ) dari pengukuran. Secara umum alat ellipsometer dapat dipergunakan untuk mengukur sifat - sifat optik suatu bahan baik padat maupun cair yang memiliki sifat isotropik (sifat optik tidak tergantung arah) ataupun anisotropik (sifat optik tergantung arah). Selain itu media yang akan diukur dapat berupa lapisan tipis (thin film) atau berupa lapisan yang tebal (bulk). Ellipsometer dapat digunakan untuk memantau fenomena perubahan suatu permukaan bahan akibat oksidasi, pemendapan lapisan, dan lain-lain, juga dapat digunakan untuk pengukuran faktor fisik dari suatu bahan yang dapat mengakibatkan perubahan sifat-sifat optik seperti medan listrik, medan magnet, tekanan dan suhu. Alat ini digunakan secara luas di berbagai industri mikroelektronika, minyak, kedokteran, dan lain-lain. Sebagai contoh penggunaan ellipsometer dalam teknologi mikroelektronika adalah menentukan ketebalan lapisan silikon teroksidasi oleh udara bebas (SiO2) yang termendap di atas permukaan wafer silikon (Si), juga memonitor pengaruh endapan dari gas nitrides, sulfides ke atas permukaan wafer silikon. Selain itu di dalam teknologi kedokteran, ellipsometer dapat digunakan untuk meneliti reaksi antigen-antibodi pada lapisan tipis [1,2]. Ellipsometer yang didesain memiliki beberapa kemudahan sebagai suatu alat ukur yang dapat dikembangkan untuk berbagai aplikasi yang lebih luas lagi. Alat ini dapat dipindah-pindahkan dengan mudah sehingga fleksibel bagi pengukuran di berbagai tempat dari struktur yang ada. Kinerja alat yang relatif mudah, beaya operasional yang relatif murah dengan tingkat akurasi yang cukup tinggi ini memungkinkan untuk didesain di berbagai laboratorium di Indonesia.
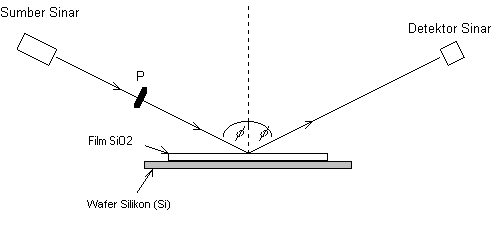
Polariser P berfungsi untuk meng-kutub-kan sinar menjadi kutub p yaitu osilasi gelombang paralel dengan bidang sinar terkutub, dan kutub s yaitu osilasi gelombang tegak lurus dengan bidang sinar terkutub. Untuk mendapatkan sifat kedua jenis pengkutuban sinar tersebut, dapat dilakukan dengan memutar polariser sebesar 90° dan 0° . Agar sinar yang datang dari sumber dapat mengenai permukaan sampel dengan baik maka dapat ditambahkan piranti slit yaitu lubang kecil yang diletakkan setelah sinar keluar dari polariser yang memungkinkan untuk mengatur diameter sinar yang mengenai permukaan sampel juga untuk mengatur intensitas sinar yang datang. Pengukuran dengan alat ellipsometer hendaknya dilakukan dalam ruangan yang cukup gelap yang memungkinkan dapat meniadakan pengaruh sinar dari sekitaran. Desain sederhana dari alat ellipsometer ini adalah dapat difungsikan hanya dengan sebuah piranti polariser tanpa harus menggunakan piranti tambahan seperti analiser.
 (Persamaan 3)
(Persamaan 3)![]() (Persamaan 4b)
(Persamaan 4b)
![]() (Persamaan 4c)
(Persamaan 4c)
![]() (Persamaan 4d)
(Persamaan 4d)
Sebagai contoh adalah jika akan dilakukan pengukuran bagi sifat optis
dari struktur media yang terdiri dari udara-SiO2-Si yaitu lapisan
SiO2 yang terbentuk di atas permukaan Si pada udara bebas, maka
struktur media tersebut dapat dilukiskan sebagai sistem 3 fase seperti
ditunjukkan pada Gambar 2 di bawah. r01 dan r12
masing-masing adalah koefisien pantulan Fresnel oleh antarmuka dari
media 0-1 dan media 1-2 yang didefinisikan pada Persamaan 4. Parameter
N0, N1, dan N2 masing-masing
adalah index bias medium 0, 1 dan 2.

Dari pengukuran yang dilakukan untuk sampel dengan struktur media seperti
yang diskemakan pada Gambar 2 tersebut, telah diperoleh hubungan R vs
f untuk
panjang gelombang 632.8 nm yang disimbolkan dengan bulatan (·
) seperti ditunjukkan dalam Gambar 3. Besarnya parameter index bias film
(N1) dan ketebalan film (d1) akan dapat
diketahui dengan melakukan fitting berdasarkan perhitungan menggunakan
persamaan 3, 4(a - d) dan 5. Prosedur fitting bagi mendapatkan nilai yang
paling tepat yang sesuai antara hasil pengukuran dan perhitungan dapat
dilakukan dengan berbagai metode, salah satunya adalah metode Powell [5]
yang dapat dilakukan dengan mudah menggunakan program komputer menggunakan
bahasa level tinggi seperti Fortran, C, dan lain-lain. Dari fitting yang
dilakukan diperoleh grafik hubungan antara R vs f
(dilukiskan dengan kurva) yang sesuai dengan hasil pengukuran dengan diperoleh
index bias bahan silikon (yang bersifat isotropik) sebesar 3.85 - i0.02
pada panjang gelombang 632.8 nm, dan lapisan SiO2 yang memendap
di atasnya memiliki index bias sebesar 1.46 [4] dengan ketebalan 15 Å
.